扇出型封装(Fan-out Packaging)
在半导体持续追求更高集成度与性能的趋势下,先进封装已成为延续摩尔定律的关键路径。

*扇出型封装,图源网络,侵删
其中,扇出型封装(Fan-Out Packaging, FOP)以其I/O密度高、封装厚度薄、电气性能优良及成本可控等优势,在智能手机、高性能计算 (HPC) 、人工智能 (AI) 及 5G 通信等核心领域获得广泛应用,成为高端芯片封装的主流选择之一。
UBM工艺:扇出型封装的关键环节
在扇出型封装的关键工艺流程中,植球工艺(Solder Ball Placement)是确保芯片与外部电路实现可靠电气与机械连接的核心步骤。
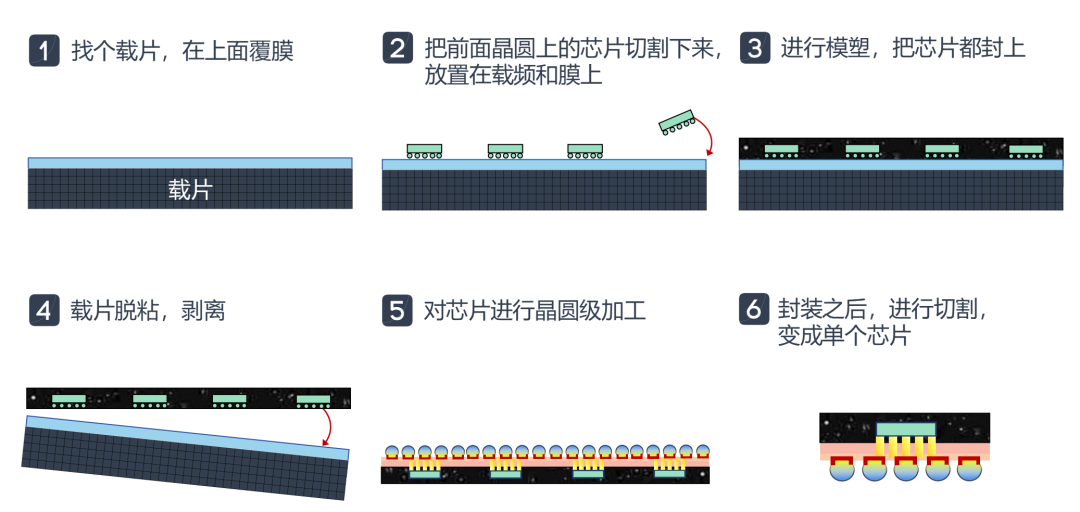
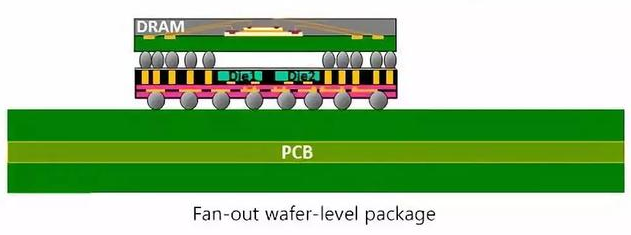
*扇出型晶圆级封装,图源网络,侵删
而植球工艺的成功率与长期可靠性,极大程度上依赖于凸点下金属化层(UBM)的质量。UBM层作为焊球与芯片焊盘之间的关键界面,其表面润湿性(Wettability)直接决定了熔融焊料能否均匀、牢固地铺展,并形成良好的冶金结合。

*显微镜下的焊球,图源网络,侵删
如果UBM表面润湿性能差,表面能低,容易导致焊料铺展不均匀,进而造成植球不良:如虚焊、焊球偏移、桥连,甚至后续使用中的早期失效,对最终封装产品的良率和可靠性构成严峻挑战。
PLASMA等离子表面处理提升焊接、键合、封装质量
等离子表面处理技术利用高活性粒子与物体表面产生化学反应或物理轰击,有效打破其惰性C-H键等弱化学键,在其表面引入含氧官能团(如-OH, -COOH),提升表面能,为焊料铺展创造理想基底。
等离子表面处理技术具有处理温度低、可控性强、兼容性高、处理均匀等优势,能够在不损伤材料结构的前提下,改善表面润湿性,在先进封装领域发挥着重要作用。
PLASMA等离子表面处理的作用:
显著提升植球良率:优化表面润湿性确保焊球精准定位、均匀熔化、良好铺展,降低植球缺陷;
增强焊点可靠性:形成更牢固、更均匀的金属间化合物(IMC)层,提升焊点长期可靠性;
保障工艺稳定性:提供稳定、一致的表面处理效果,降低因表面状态波动带来的工艺风险。

